BGA封装
贡献者:dolphin 浏览:2004次 创建时间:2014-06-11
-
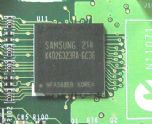 BGA封装,亦称球栅阵列封装技术、高密度表面装配封装技术,英文全称为Ball Grid Array Package,其I/O端子以圆形或柱状焊点按阵列形式分布在封装下面,成球状并排列成一个类似于格子的图案。
BGA封装,亦称球栅阵列封装技术、高密度表面装配封装技术,英文全称为Ball Grid Array Package,其I/O端子以圆形或柱状焊点按阵列形式分布在封装下面,成球状并排列成一个类似于格子的图案。20世纪90年代随着技术的进步,芯片集成度不断提高,I/O引脚数急剧增加,功耗也随之增大,对集成电路封装的要求也更加严格。为了满足发展的需要,BGA封装开始被应用于生产。该技术的出现成为CPU、主板南、北桥芯片等高密度、高性能、多引脚封装的最佳选择。
BGA的封装类型多种多样,其外形结构为方形或矩形。根据其焊料球的排布方式可分为周边型BGA、交错型BGA和全阵列型BGA;根据其基板的不同,主要分为三类:PBGA(PlasticballZddarray塑料焊球阵列)、CBGA(ceramicballSddarray陶瓷焊球阵列)、TBGA (tape ball grid array载带型焊球阵列)。
1.I/O引脚数虽然增加了,但引脚间距并没有减小反而增加了,提高了组装成品率。
2.虽然功耗增加,但BGA能用可控塌陷芯片法焊接,由此改善它的电热性能。
3.该技术的组装可用共面焊接,从而能大大提高封装的可靠性。
4.该技术实现的封装寄生参数减小,CPU信号传输延迟小,使用频率大大提高。
5.厚度和重量都较以前的封装技术有所减少。
6.BGA封装占用基板的面积比较大。
采用BGA技术封装的内存,可以使内存在体积不变的情况下,内存容量提高两到三倍,BGA与TSOP相比,具有更小体积,更好的散热性能和电性能。BGA封装技术使每平方英寸的存储量有了很大提升,采用BGA封装技术的内存产品在相同容量下,体积只有TSOP封装的三分之一;与传统TSOP封装方式相比,BGA封装方式有更加快速有效的散热途径。
基板或中间层是BGA封装中非常重要的部分,除了用于互连布线以外,还可用于阻抗控制及用于电感/电阻/电容的集成。因此要求基板材料具有高的玻璃转化温度rS(约为175~230℃)、高的尺寸稳定性和低的吸潮性,具有较好的电气性能和高可靠性。金属薄膜、绝缘层和基板介质间还要具有较高的粘附性能。
1.线键合PBGA的封装工艺流程
(1)BGA基板的制备
在BT树脂/玻璃芯板的两面层压极薄(12~18μm厚)的铜箔,然后进行钻孔和通孔金属化。用常规的PCB加3232艺在基板的两面制作出图形,如导带、电极、及安装焊料球的焊区阵列。然后加上焊料掩膜并制作出图形,露出电极和焊区。为提高生产效率,一条基片上通常含有多个PBG基板。
(2)工艺流程
圆片减薄→圆片切削→芯片粘结→等离子清洗→引线键合→等离子清洗→模塑封装→装配焊料球→回流焊→表面打标→分离→最终检查→测试斗包装 芯片粘结采用充银环氧粘结剂将IC芯片粘结在基板上,然后采用金线键合实现芯片与基板的连接,接着模塑包封或液态胶灌封,以保护芯片、焊接线和焊盘。使用特殊设计的吸拾工具将熔点为183℃、直径为30mil(0.75mm)的焊料球62/36/2Sn/Pb/Ag或63/37/Sn/Pb放置在焊盘上,在传统的回流焊炉内进行回流焊接,最高加工温度不能够超过230℃。接着使用CFC无机清洗剂对基片实行离心清洗,以去除残留在封装体上的焊料和纤维颗粒,其后是打标、分离、最终检查、测试和包装入库。
2.C-CBGA的封装工艺流程
(1)基板
FC-CBGA的基板是多层陶瓷基板,它的制作是相当困难的。因为基板的布线密度高、间距窄、通孔也多,以及基板的共面性要求较高等。它的主要过程是:先将多层陶瓷片高温共烧成多层陶瓷金属化基片,再在基片上制作多层金属布线,然后进行电镀等。在CBGA的组装中,基板与芯片、PCB板的CTE失配是造成CBGA产品失效的主要因素。要改善这一情况,除采用CCGA结构外,还可使用另外一种陶瓷基板--HITCE陶瓷基板。
(2)工艺流程
圆片凸点的制备呻圆片切割呻芯片倒装及回流焊-)底部填充呻导热脂、密封焊料的分配+封盖斗装配焊料球-)回流焊斗打标+分离呻最终检查斗测试斗包装。
3.线键合TBGA的封装工艺流程
(1)BGA载带
TBGA的载带通常是由聚酰亚胺材料制成的。在制作时,先在载带的两面进行覆铜,然后镀镍和镀金,接着冲通孔和通孔金属化及制作出图形。因为在这种引线键合TBGA中,封装热沉又是封装的加固体,也是管壳的芯腔基底,因此在封装前先要使用压敏粘结剂将载带粘结在热沉上。
(2)装工艺流程
圆片减薄→圆片切割→芯片粘结→清洗→引线键合→等离子清洗→液态密封剂灌封→装配焊料球→回流焊→表面打标→分离→最终检查→测试→包装。
1.由于BGA的管脚较密,一般无法直接从顶层引出,需要错位打过孔引出到底层,除了最外层的管脚。但是如果要用热风枪焊接,就应该全部打过孔到底层,并且注意排列整齐。
2.焊料溶液涂在顶层焊盘上和焊盘的引出过孔上,然后载涂在底层的焊盘引出过孔上。配置溶液的松香一定要干净,洗板水也一定要干净。
3.BGA芯片对正管脚,这点最难,不过大体对正即可,管脚不要碰到相邻管脚焊盘的引出过孔就可以。
4.用热风枪吹,但不是吹顶层(顶层芯片盖住了没法吹),而是吹底层的焊盘引出过孔,当然,你可能需要两个东西将电路板架高架空,你的热风枪要从下面吹这些焊盘的引出过孔,注意热风枪不要加吹头,以免加热不均匀,最好直接用粗口吹,一般就能均匀加热,因为BGA封装的芯片面积不大。由于每个焊盘都有引出过孔,可以迅速的将热量传到顶层焊盘上,而顶层焊盘上又涂了焊料溶剂,BGA芯片上的管脚很容易熔化。10秒钟左右,等松香的烟没了就可以了。
5.干净的洗板水洗掉松香的黒迹即可。
TinyBGA英文全称为Tiny Ball Grid Array(小型球栅阵列封装),属于是BGA封装技术的一个分支。是Kingmax公司于1998年8月开发成功的,其芯片面积与封装面积之比不小于1:1.14,可以使内存在体积不变的情况下内存容量提高2~3倍,与TSOP封装产品相比,其具有更小的体积、更好的散热性能和电性能。
TinyBGA封装内存采用TinyBGA封装技术的内存产品在相同容量情况下体积只有TSOP封装的1/3。TSOP封装内存的引脚是由芯片四周引出的,而TinyBGA则是由芯片中心方向引出。这种方式有效地缩短了信号的传导距离,信号传输线的长度仅是传统的TSOP技术的1/4,因此信号的衰减也随之减少。这样不仅大幅提升了芯片的抗干扰、抗噪性能,而且提高了电性能。采用TinyBGA封装芯片可抗高达300MHz的外频,而采用传统TSOP封装技术最高只可抗150MHz的外频。
TinyBGA封装的内存其厚度也更薄(封装高度小于0.8mm),从金属基板到散热体的有效散热路径仅有0.36mm。因此,TinyBGA内存拥有更高的热传导效率,非常适用于长时间运行的系统,稳定性极佳。

 RSS订阅
RSS订阅